エリプソメトリー FAQ
エリプソメトリーとは、偏光した光を用いて薄膜やバルク物質の特性を調べる測定法です。サンプルに光が当たると、サンプルと光は相互作用して反射光や透過光の偏光状態は変化します。
エリプソメトリーの結果は、一般的にプサイ(Ψ)とデルタ(⊿)の2つの値で表されます。データは光学定数や薄膜の膜厚などの物理量を測定するための解析に用いられます。プサイ(Ψ)とデルタ(⊿)はエリプソメトリー測定結果の生データで、サンプルと相互作用した光の偏光状態の変化を表しています。入射光線には、入射面に対して平行な電場成分を持つ成分(p偏光)と、垂直な電場成分を持つ成分(s偏光)が含まれています。
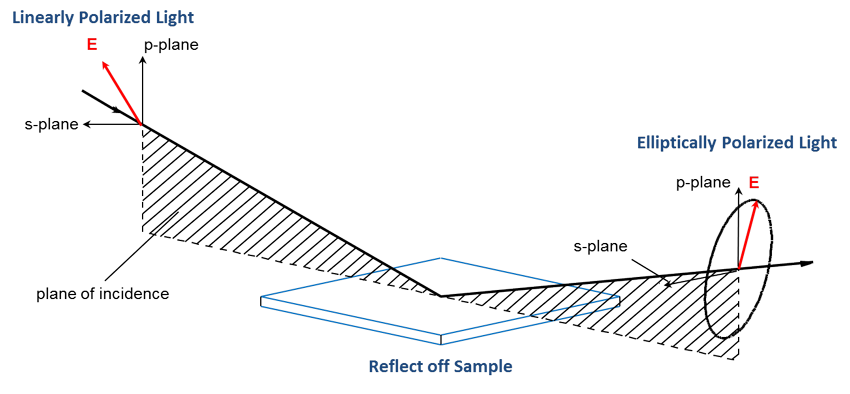
p偏光の光とs偏光の光は物質表面で異なる振る舞いをします。そのため、反射光の偏光状態は入射光とは違ったものになります。反射光の偏光状態は、強度比(tanΨ)と位相差(⊿)を用いて、以下のように表されます。

ここで Rpと Rs はそれぞれp偏光とs偏光に対する、フレネルの反射係数です。
エリプソメトリーでは、プサイ(Ψ)とデルタ(⊿)の2つの値を測定します。これらはサンプルと相互作用した光の偏光状態の変化に関係しています。単独ではΨと⊿は参考になる値とは言えません。
私たちが実際に知りたいのは、薄膜の膜厚、光学定数、屈折率、表面の粗さなど、サンプルの物理的な性質です。これらはサンプルとの光の相互作用を記述したモデルを作成するための、様々な方程式とアルゴリズムによって 、Ψと⊿の性質から求められます。複数波長でのエリプソメトリー、すなわち分光エリプソメトリー測定にはいくつかの利点があります。
主な利点としては以下のものが挙げられます。
A.唯一の解を得ることができる。
B.物質の性質への感度が良くなる。
C.特定の目的において、興味のある波長での光学特性を得ることができる。
では、これら3つを以下で詳しく説明していきます。
A. 唯一の解を求める
エリプソメーターの性能を向上させる方法として、測定する波長範囲を広く、測定波長数を多くすることがあげられます。そして、そのそれぞれの新たな波長での測定結果はサンプルの情報を含んでいます。
初期のエリプソメトリーでは、レーザーが光源として用いられ、1つの波長のみで測定結果が求められていました。2つの測定値(プサイ(Ψ)とデルタ(⊿))からは、サンプルの性質のうち2つの未知数しか決定できません。既知の基板の上に単層薄膜があるという単純な場合でも、薄膜の膜厚と屈折率を1つに決めることはできません。薄膜に吸収がある場合や、深さ方向への屈折率勾配がある場合、表面や層間が粗い場合などでは誤った結果を得る可能性があります。
下の図は完全に透明な膜の場合、単一波長のエリプソメトリーでは膜厚の増加とともにΨ・⊿が周回軌道をとる、すなわちΨと⊿が周期的に変化することを示しています。このため、単一波長のエリプソメトリーでは唯一解を得ることができません。正しい膜厚を得るためには単一波長エリプソメトリー以外の手段での情報と組み合わせる必要があります。
これに対し分光エリプソメトリーでは測定値が未知数より多いため膜厚を決定することができます。屈折率が波長依存性を持つのに対し、膜厚は一定です。たとえば波長が100種類の分光エリプソメトリーを用いれば未知数が101個(膜厚と各波長での屈折率)であるのに対し、200種類のデータ(各波長でのΨと⊿)を測定することができます。このため分光エリプソメトリーによる測定では周期性の問題を回避して唯一解を求めることができます。
下の図は、単一波長エリプソメトリーでは区別できない3つの場合の分光エリプソメトリーでの測定結果です。500nmの波長では同一のデータとなりますが、分光エリプソメトリーではまったく違った測定結果を示しています。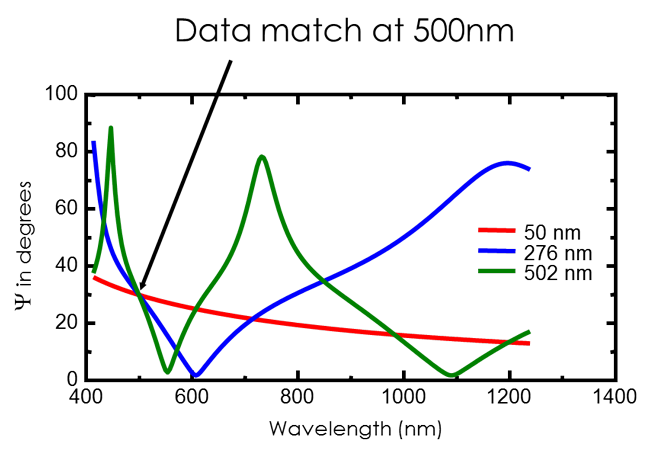
B. 物質の性質への感度が良くなる
物質の性質を測定するには、特定の波長範囲での測定が重要な場合があります。たとえば透明な導電性酸化物(TCO)には、近赤外領域まで裾の広がる赤外域での強い吸収がありますし、可視域での測定ではTCOの導電性を確認することはできません。また、分子結合の情報は中赤外の領域にのみ現れます。振動数の小さい光だけが物質中の原子を振動させることができます。紫外スペクトルは電子遷移に関係していて、これは物質の構造に関する情報を持っています。たとえばSiの薄膜における紫外領域での吸収スペクトルの形状は、Siの結晶度を決定するのに用いられます。アモルファスであれば吸収はなだらかになります。結晶度が増大するに従い、紫外領域での吸収はそのピークが区別できるようになります。
下の図はSiの結晶度とその吸収の様子を示しています。広い波長範囲をカバーする分光エリプソメトリーでは、すべての波長での測定からこれらの利点を同時に得ることができます。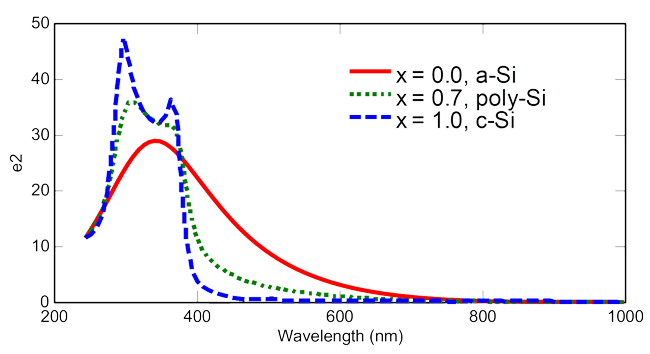
C. 特定の目的における関心のある波長での光学特性を得ることができる
多くの応用分野について特定の波長における光学的性質が問題となります。たとえば、半導体産業ではリソグラフィーが欠かせないので、紫外領域(158nm, 193nm, 248nm…)でのエリプソメトリー測定が求められます。ディスプレイ産業では、可視域の特性を測定することが重要になってきます。光学コーティング産業では、可視域か近赤外域、中赤外域、それぞれの設計する波長領域に関する測定が求められます。
J.A.Woollam社の分光エリプソメーターのラインナップでは33ミクロンから140nmまでの広い波長範囲をカバーしています。この広い波長範囲により、あらゆる応用分野においてのお客様の要求を満たすための柔軟性を実現することができます。分光エリプソメトリーは薄膜の膜厚変化に非常に高感度に働きます。薄膜の膜厚が増大すると表面での反射光と薄膜内を通過する光との間の差が大きくなります。
この様子は下の図に示されています。膜厚の増大によって、膜厚だけでなく屈折率にも関係した位相遅れが起こります。そのため、分光エリプソメトリーの結果は薄膜の膜厚と屈折率の双方を正確に測定するための情報を含んでいるのです。
分光エリプソメトリーの測定結果は干渉縞の位置と数に基づいた膜厚に関する情報を提供します。下のグラフは、それぞれ異なった膜厚を持つSiO2膜のプサイ(Ψ)データを示しています。膜厚(T)が増加すると、ピーク位置は長波長側に移動します。

分光エリプソメトリーは、サブナノメートルオーダーの厚さをもつ表面層の存在に対して感度があります。この感度は下のグラフに示しているように、主に位相差デルタ(⊿)の変化に由来します。下のグラフはSi基板上のそれぞれ異なった膜厚のシリコン酸化膜の⊿データです。しかし、光とこれらの極薄膜の相互作用からは膜厚と屈折率を同時に求めるのに十分な精度の感度は得られません。この場合はより厚い膜の測定から得られた屈折率をおおよその屈折率として仮定し、膜厚だけを求めるのが安全です。極薄膜の膜厚と屈折率が同時に求められる場合も稀にあります。
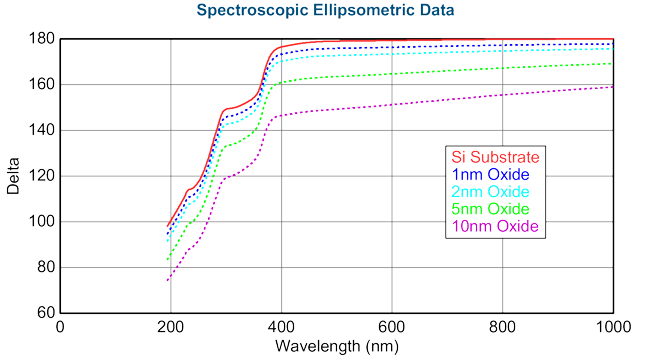
H. Arwin and D.E. Aspnes “Unambiguous Determination of Thickness and Dielectric Function of Thin Films by Spectroscopic Ellipsometry”, Thin Solid Films, 113 (1984) 101.
分光エリプソメトリーで測定できる膜厚の上限は測定波長範囲に依存します。膜が厚くなればなるほど短波長領域でのデータの多数の振動を測定することは難しくなります。それに対し、長波長領域では振動を区別することが可能です。そのため50ミクロンまでの膜厚を測定するには近赤外や中赤外領域での測定が用いられます。
しかしこれらの膜厚は標準的な分光エリプソメトリー測定の範囲を超えていますし、膜の均一性がますます重要となります。大部分の可視域から近赤外域測定における膜厚の上限値としては、5ミクロン以下が推奨されます。1ミクロンから5ミクロンの膜についても、膜厚を決定するために複数の入射角での測定を行い、信頼性を高めるのが良いでしょう。プサイ(Ψ)とデルタ(⊿)の振動の形状は、膜厚だけでなく膜の屈折率にも依存します。 下の図は特定の屈折率を持つバルク表面で、反射した光に関するΨデータの振動を表しています。振動の強度によって、膜の正しい屈折率を求めることができます。それぞれの屈折率に応じて、異なった強度のΨデータが得られることが示されています。
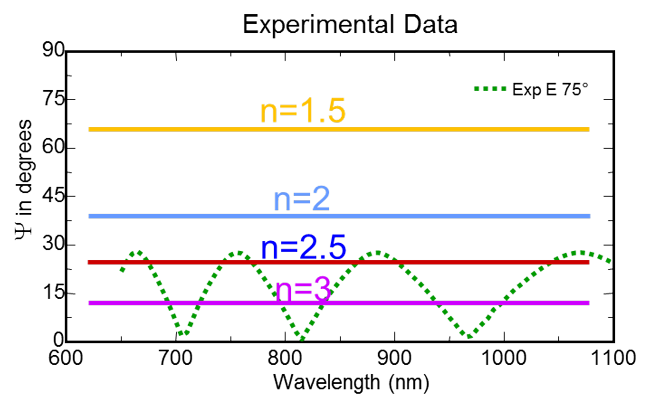
現在、エリプソメトリーはさまざまな薄膜の測定に用いられています。表面での鏡面反射さえあれば基本的にどのような物質でも測定できます。ですが、コーティングが粗すぎると、プローブ光が散乱されてディテクターに入らず、エリプソメトリー測定ができません。
分光エリプソメトリー測定は一般的に誘電体、有機物、半導体、金属などに対して行われています。それぞれの膜は等方性の可能性もあれば異方性を持つ可能性もありますし、均質な場合も勾配のある場合もあります。分光エリプソメトリーは、複数の異なる膜からなる多層膜の測定にも用いられています。膜厚を求めるにあたっての唯一の制約は、光が膜の下にある基板に当たって戻ってこなくてはいけない、ということだけです。分光エリプソメトリーは多くの種類の吸収膜の測定に用いられ、成功を収めています。膜厚を求めたい場合は光が膜内を通って戻ってくるように吸収膜は十分に薄い(一般的には50nm以下)必要があります。吸収膜の未知数がいくらあるのかも考慮しなくてはいけません。
エリプソメトリー測定は一般的にはブリュースター角(Brewster Angle)に近い斜めの入射角を用いて行われます。初期のエリプソメトリーにおいてはブリュースター角は重要視されていました。エリプソメトリーの精度はブリュースター角で最も高くなるためです。
しかし、現在の補償子を組み込んだエリプソメトリーにおいては、ブリュースター角はそれほど重要視されなくなりました。(Question 14参照)
ですが、偏光状態の最大の変化はブリュースター角に近い斜めの入射角の場合に起こります。一般的なエリプソメトリー測定は、50度~75度の入射角範囲で行われます。単層の膜厚と屈折率を求めるための一般的な測定は単入射角での測定で十分ですが、サンプルが複雑になれば多入射角測定の必要性が高まります。
厚い膜(1ミクロン以上)や屈折率勾配のある膜、異方性のある膜、複雑な多層膜の場合は2つか3つの入射角を用いて測定することをお勧めしています。多入射角での測定が必要でない単純な測定の場合でも、多入射角で測定することによってモデルが唯一であるという信頼性が増します。「in-situ」とはラテン語で「その場で」という意味です。エリプソメトリーにおいてはサンプルが特別なチャンバーやセルの中にあるままで測定が行われることを意味しています。in-situエリプソメトリーでは、エリプソメーターをプロセスチャンバーに取り付けるか、エリプソメーターのベース部分にプロセスチャンバーやセルを搭載するかのどちらかが必要です。
下の写真は、原子層堆積(Atomic layer deposition:ALD)のチャンバーに分光エリプソメーターM-2000を搭載した装置で、チャンバー内では膜が堆積されています。表面のin-situ測定では一層ごとの成長を観測することができます。
金属酸化膜(Al2O3, Ta2O5, TiO2)の厚さをin-situエリプソメトリーの観測によるALDサイクルの回数の関数として求めています。
小さなプロセスチャンバーやセルであれば、エリプソメーターのベース部分に取り付けることができ、膜が変化する様子をin-situ測定することが可能です。溶液セルや電気化学セル、QCMセルは簡単にエリプソメトリーの装置に取り付け可能で、プロセスの変化が起こっている間、個液界面を観察することができます。ヒートステージやクライオスタットも簡単に取り付けられ、サンプルの温度変化をin-situ測定するのに最適です。
E. Langereis, S.B.S. Heil, H.C.M. Knoops, W. Keuning, M.C.M. van de Sanden, W.M.M. Kessels, “In situ spectroscopic ellipsometry as a versatile tool for studying atomic layer deposition”, J. Phys. D: Appl. Phys., 42 (2009) 9.
分光エリプソメトリー測定と分光光度測定は、ともに光を用いた測定技術です。分光エリプソメトリーが光の偏光状態の変化を測定しているのに対し、分光光度測定では、反射光あるいは透過光の強度を測定します。2つの技術はしばしば相補的であり、吸収のある薄膜を測定する場合に一緒に用いることでより多くの情報を得ることができます。しかし分光エリプソメトリーにはいくつかの重要な利点があります。
まず位相差デルタ(⊿)の情報を取得します。⊿は極薄膜(膜厚10nm以下)の測定において非常に高感度です。左下の図はSi基板上にある10nmの厚さのSiO2膜について、0.1nmの膜厚変化を与えたときの反射率変化を示しています。一般的な反射率計は0.1%より良い精度で強度を測定することができません。ですから反射率測定は極薄膜の小さな変化に対し感度が十分ではありません。 エリプソメトリーによる同様の膜厚変化に対する測定結果の変化は、下の図をご覧ください。一般的なエリプソメーターはプサイ(Ψ)とデルタ(⊿)に関して、それぞれ0.02度と0.1度より良い精度を持っています。この技術を用いることで簡単にサブオングストロームオーダーの膜厚変化も捉えることができます
反射率計とエリプソメーターの比較
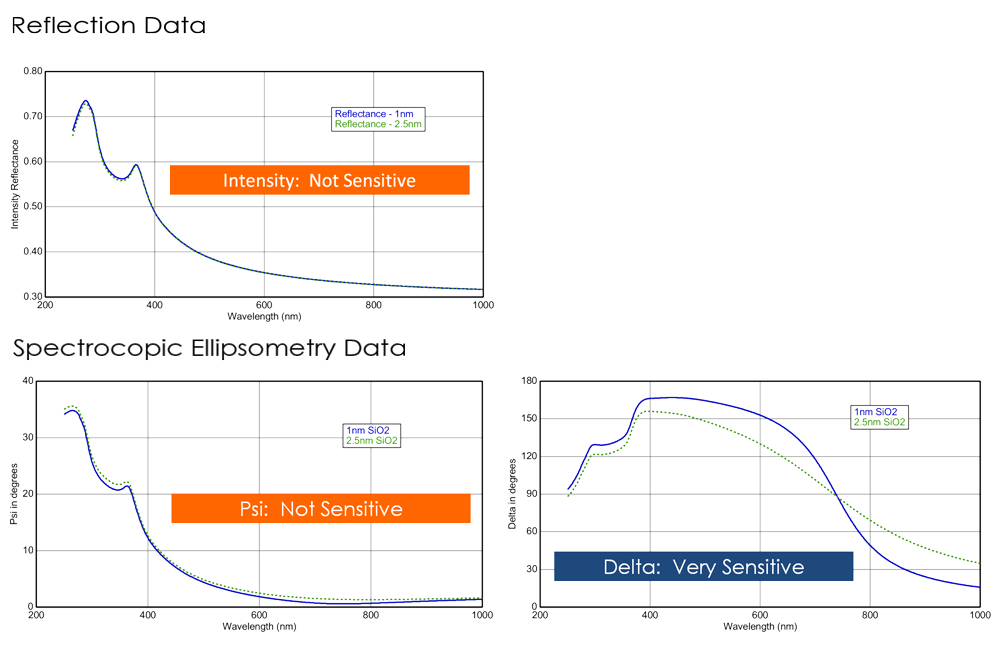
上図:Si基板上の膜厚10nmのSiO2膜と、そこから0.1nmの膜厚変化があった場合、それぞれにおける反射率測定とエリプソメトリー測定の結果。エリプソメトリーの結果(下図)では、位相差デルタ(⊿)の鋭敏な変化が見られます。
2つ目の利点は、エリプソメトリーでは偏光状態を測定するのにそれぞれの偏光成分の絶対強度を測定するのではなく、その比を測定することにあります。それゆえに、エリプソメトリー測定では光が弱い場合や強度が安定しない場合でも正確に測定することが可能です。
3つ目は標準サンプルなどが必要ない、という点です。反射率測定では光の絶対強度を測定しなくては いけません。そして定量的な測定には正確な標準サンプルが必要です。標準サンプルは測定の正確さを保つために、常にメンテナンスをしなくてはいけなくなります。すべてのWoollam社のエリプソメーターには、偏光状態を操作するための補償子が入っています。VASEとVUV-VASEにはWoollam社の特許であるAutoRetarder®(自動位相調整器)がサンプルと偏光子の間に入っています。また、M-2000、alpha-SE、IR-VASEには回転補償子が搭載されています。エリプソメーターに補償子を使用することはいくつかの利点があります。
- どのようなサンプルに対しても高い精度で測定することができる。
- プサイ(Ψ)とデルタ(⊿)がフルレンジで測定できる。(Ψ:0~90度、⊿:0~360度)
- 偏光解消が測定できる。(Question 15参照)
- ミューラー行列のうち、より多くの成分が測定できる。(Question 16参照)
自動位相調整器 (AutoRetarder)
自動位相調整器(AutoRetarder)はコンピュータで制御されるMgF2でできたベレークの波長板(補償子)で、入射した光にリターダンスを発生させます。補償子がコンピュータで制御されていますので、140~2500nmのスペクトル範囲において適切な値(0~90度)のリターダンスを発生させることができます。どのようなサンプルにおいても、それぞれ最高の測定精度が得られるようなリターダンスを自動的に発生させることができます。
回転補償子
回転補償子型とは、リターダンスを調整するためにサンプルの前もしくは後ろに置かれた補償子を回転させる装置構成です。同時にたくさんの偏光状態を測定して分光エリプソメトリーデータを得ることができます。全波長範囲をわずかな時間で同時に測定するCCDディテクターと一緒に用いることができるところが利点です。わずか1秒以内の間に数百種の波長で高精度なエリプソメトリーデータを得られる方法はこの技術のみでしょう。
分光エリプソメトリーではサンプル表面で反射された、あるいはサンプルを透過した光線の偏光状態の変化を測定しています。もし測定装置とサンプルの関係が理想的な状態ならば、入射光と反射光(透過光)はともに全偏光です。しかし実際には測定装置もサンプルも理想的な関係ではなく光を非偏光にします。偏光解消とは非偏光状態の光の割合を示しています。
J.A.Woollam社のすべてのエリプソメーターはAutoRetarder(自動位相調整器)、もしくは補償子のどちらかを備えているため、偏光解消での測定が可能です。測定装置の偏光解消の原因としては、角度の広がりもしくはバンド幅効果です。サンプルによる偏光解消の原因としては、サンプルの不均一性もしくは裏面反射が挙げられます。
偏光解消での測定はサンプルに不均一な薄膜やパターン化された層がある場合、すなわちサンプルが非理想的な場合に有効です。また、透明な基板上の薄膜を測定する時にも役立ちます。光が基板の裏面で反射されて戻ってくる場合、基板と薄膜の界面や薄膜表面で反射した光とのコヒーレント性が失われます。このとき、偏光解消は裏面反射の効果を定量的に評価するのに用いられます。ミューラー行列とは、特定のサンプルによる光の偏光状態の変化を完全に記述する行列のことです。全偏光の変化のみ記述可能なジョーンズ行列(Jones-Matrix)と違い、ミューラー行列は全偏光も部分偏光も、非偏光の光でさえも記述することができます。
ミューラー行列は4×4の行列で、4つの成分を持つストークスベクトルと対応して、反射や透過での偏光状態の変化を記述しています。補償子(Question 14参照)を使用しているエリプソメーターは、ミューラー行列の16成分のうち、12成分を測定することができます。補償子がサンプルの前後両方に配置されている場合は、ミューラー行列の16成分すべてを測定することができます。しかしミューラー行列には冗長性があり、16成分すべてを測定しなくてもサンプルによる偏光状態の変化を記述することができます。
下の例は等方的なサンプルにおけるミューラー行列を表しています。もし偏光解消がなければ、2つのパラメータ(プサイ(Ψ)とデルタ(⊿))だけを測定すればよいことがわかります。偏光解消がある場合でも、ミューラー行列の3成分を測定すればよいのです。異方性と偏光解消がある場合、ミューラー行列の独立したパラメータは7つになります。より複雑な場合、たとえば交差偏光や散乱効果がある場合や、さらにはモデル化することができない場合でさえ、ミューラー行列の各成分を用いてサンプルを測定することができます。
どのエリプソメーターがお客様の条件を満たすかを決める最も良い方法は、まず専門家と話すことです。弊社では実際にデモ機を持っていますので、豊富な知識のあるエンジニアがお客様のアプリケーションにあった装置の紹介や実際に測定をすることができます。 また、実際にお客様のもとへ伺い、様々な解析事例やご相談にのることも可能です。
どのタイプのエリプソメーターが、お客様の条件に合っているか、以下の項目を参考にしてください。
波長範囲
測定可能な波長範囲と数は、エリプソメーターで薄膜を測定解析する上でとても重要な要素です。波長範囲が広く点数が多ければそれだけ正確に解析することのできる可能性が高まります。
入射角範囲
多くのサンプルは1つの入射角のみで測定することができますが、多層膜や異方性のあるサンプルなど、複数の入射角での測定が必要な場合もあります。また複数の入射角で測定することで、解析モデルが一意に定まる可能性が高まります。お手持ちのサンプルについて多入射角での測定が必要かどうか、ぜひ弊社のエンジニアまでお問合せください。
測定スピード
測定スピードはin-situでの測定(Question 12参照)やサンプル上の複数の点でのマッピング測定などの場合において非常に重要な要素となります。ほとんどのエリプソメーターは1秒にも満たない時間で測定することができますが、基本的な技術では単一の、もしくは限られた数点の波長でしか測定できません。実時間エリプソメトリー測定の場合は、弊社のM-2000のようなCCDでの検出が望ましいでしょう。
正確さ
多くのエリプソメーターによる測定の正確さと再現性は、一般的に必要とされる程度を上回っています。
たとえば、ゲート酸化膜の膜厚測定の再現性は0.003nmか、それよりもよいものです。
テクノロジー
エリプソメーターに使用されている技術は直接的に重要でないといった場合もあります。
しかしこれらの技術によって波長範囲や測定スピード、そして正確さといった特徴が実現されています。
特徴
上に挙げた特徴や仕様だけでなく、分野に応じた別の必要性や、エリプソメーターが後々必要とされるサンプルが出てきた場合に応じてアップグレードできるかどうかなども考慮に入れていただけるとよいかもしれません。オプションの例としては、マッピング用サンプルステージ、溶液セル、ヒートステージ、クライオスタット、集光ビーム、波長範囲の拡張など様々ご用意しています。ぜひご相談ください。
金額
様々なアプリケーションに対応した、数々の装置をご紹介いたします。低価格の簡易装置から、フルスペックの装置までございますので、まずはご相談ください。何十年にもわたってリンカーンのネブラスカ大学で研究されてきたエリプソメトリー技術の要望が時代とともに大きくなってきたことに答えるため、米国本社である J.A. Woollam 社は1987年に設立されました。私たちは分光エリプソメトリーの開発と改良だけに集中してきました。それは、100以上もの米国での特許取得に表されていると言えます。
スタッフの半分以上は科学者やエンジニアで、1つの技術に向かって常に献身的に取り組んでいます。 それゆえにJ.A. Woollam社は他の追随を許さない、分光エリプソメトリーの高い技術や知識を有しています。また、アプリケーションエンジニアはほとんどすべてのサンプルを見てきた経験があります。この知識と多能な生産ラインとの融合により、お客様のどんなアプリケーションのサポートも可能にしています。エリプソメトリー解析ソフトウェアでは、産業用アプリケーションの応用に対応しとても使いやすく設計されていて、同時に非常に複雑なサンプルにも対応できます。
私たちは常に高い水準の技術と知識を持って、お客様のサポートに力を尽くしています。参考資料:General_03_Polarization on the Prarie History of Ellipsometry in Nebraska_日本語版
